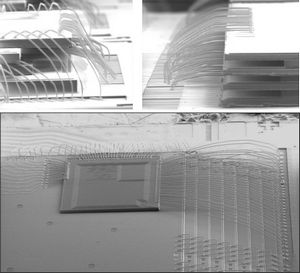
Немногим менее года назад на прилавках магазинов показались процессоры Ivy Bridge – первые процессоры, изготовленные по разработке 22нм, и, что серьёзнее, первые, применяющие «tri-gate» транзисторы. Если сравнивать с предшественниками эти процессоры были ощутимо стремительнее и потребляли очень мало энергии.
Но, в конечном итоге, это была только попытка выжать еще мало из технологии и материалов производства, уже практически достигнувших предела собственных возможностей.К счастью, имеется вторая развивающаяся разработка, которой под силу продолжить жизнь кремниевой электроники: трехмерная интеграция. Это разработка, которая разрешает создавать совокупности с высокой степенью интеграции, путём вертикальной укладки друг на друга и соединения разных слоёв, например, полупроводниковых кристаллов.
К примеру, возможно забрать кристалл памяти DRAM и поместить его сверху на кристалл процессора. В следствии, раньше пребывавшие на расстоянии нескольких сантиметров части, сейчас находятся менее чем в миллиметре друг от друга.
Это уменьшает энергопотребление – чем больше расстояние, тем сложнее передача данных, и увеличивает пропускную свойство.Потенциальные преимущества 3D-интеграции включают в себя многофункциональность, увеличение производительности, понижение энергопотребления, миниатюризацию, повышение и удешевление надежности. Давайте давайте разберемся чуть подробнее в том, что же собой воображает эта разработка.
Смотрите кроме этого: Шпион в твоем кармане
Эксперты управления по разработке морских совокупностей ВМС США (NAVSEA), совместно с ребятами из университета Индианы совершили увлекательный опыт: Двадцати добровольцам раздали смартфоны с установленным на них намерено созданным шпионским ПО.Вредоносное ПО делает фотоснимки и передает их на сервер, кроме этого передаются эти с вторых датчиков смартфона. На сервере из фотографий посредством данных с положения аппарата и датчиков движения строится трехмерная модель помещения. В среднем, полученные модели были достаточно подробными — они содержали порядка 180-800 тысяч трехмерных точек.
Мотивирующий пример из области недвижимостиПредставьте, что вы и еще 10.000 человек живёте в комфортном коттеджном поселке из одноэтажных домиков. Сравните эту картину со сценарием, где то же число людей населяет одно высотное строение.Какую территорию будет занимать каждое из этих поселений? какое количество времени Вам пригодится на то, дабы нанести дружеский визит привычному?
Во какое количество обойдется поддержание инфраструктуры для того чтобы поселения (дороги, электро- и водоснабжение и т.д.)? Уверен, что это умственное упражнение не позовёт трудностей, и не буду приводить ответы, в виду их очевидности.Мало историиСовременный уровень развития разработки интеграции – это уже, по сути, третье её поколение.Первоначально всё начиналось с попыток объединения двух кремниевых кристаллов на плоскости и упаковки их в единый корпус.
Таковой подход употреблялся, к примеру, при производстве Pentium Pro – во второй половине 90-ых годов двадцатого века разработка производства не разрешала интегрировать большой L2-кэш в кристалл процессорного ядра. Исходя из этого L2 кэш был выполнен как отдельный кристалл и находился в общем корпусе с процессорным кристаллом.Частично открытый корпус Pentium Pro. Кристалл кэша – справа.
Возможно подметить, как регулярна его литография, если сравнивать с процессорным ядром.Страно, но спустя 15 лет этот подход живее всех живых, хоть и пара изменился. Упоминаемая в литературе как «advanced packaging», его современная реализация предполагает применения кремниевой пластины-ретранслятора (transposer) как «мини-материнской платы», соединяющей пара кристаллов.
Приимущество для того чтобы подхода в том, что возможно расположить кристаллы значительно ближе, чем ранее, и наряду с этим не нужно вносить никаких трансформаций в их дизайн. Ожидается, что данный подход будет использоваться в новых поколениях multi-GPU видеоплат от Nvidia и AMD.Следующий ход в развитии носит название 3d stacking. Хоть слои компонентов и находятся один поверх другого, но соединения между слоями находятся лишь по краям.
Таковой подход, к примеру, в далеком прошлом и удачно применяет компания Apple для соединения DRAM и CPU в разнообразных гаджетах.3d stackingНу и последний ход – 3аккумуляторная TSV (through-silicon via), характеризуется наличием сквозных соединений между слоями в произвольной точке. Сейчас массово используется лишь для соединения с оптическими сенсорами в разнообразной цифровой фото/видео технике.3d TSVФакторы, воздействующие на развитие 3d интеграцииОсновные факторы, воздействующие на развитие данной разработке, представлены на следующем рисунке.
Остановимся на них подробнее.уменьшение и Миниатюризация цены. В случае если отыскать в памяти размеры процессоров 10 лет назад, то разумеется, что при сохранении размеров они не вписались бы в формат современных гаджетов. Тех же телефонов, к примеру. Казалось бы, уже более чем сорокалетнее выполнение закона Мура дает ответ данной неприятности, действенно уменьшая площадь с каждым поколением разработки производства.
Но наряду с этим не следует забывать, что число транзисторов и сложность устройств в них растет, оказывая ровно противоположный эффект. Помимо этого, цена производства растет приблизительно в 2.5 раза на любой ход от одного техпроцесса к второму. Как тут окажет помощь 3d интеграция? Что касается размеров, выполнение того же количества транзисторов в нескольких вертикально расположенных слоях – более привлекательно с позиций линейных размеров.
Тут всё легко.Что касается стоимости – увидим, что хоть суммарная площадь кремния, применяемого в устройстве, остается фактически неизменной, но размер каждого отдельного кристалла значительно уменьшается в разы. Это воздействует на таковой ответственный параметр, как долю выхода годных кристаллов. Поясню на примере: площадь кристалла процессора Itanium 2 образовывает приблизительно 430мм2.
Из-за столь внушительных размеров, только ~15% кристаллов, произведенных на одной кремниевой пластине («вафле») (~10 штук), функционируют. Чем больше площадь, тем больше возможность того, что на ней встретится хотя бы один недостаток изготовления. А цена изготовления одной пластины образовывает порядка $6000. Нетрудно посчитать себестоимость одного кристалла для серверного процессора.
Для процессоров, не относящихся к серверному рынку, выпуск целесообразен, в случае если часть годных образовывает не меньше 90%. Что не в последнюю очередь достигается за счет намного меньшей площади. Так, применение 3d интеграции разрешит радикально снизить цена, прежде всего для сложных устройств.Intel Atom (Diamondville). Площадь 25мм2Следующий фактор: соотношение энергопотребления и производительности.
Рост вычислительной мощности ведет к росту требований к пропускной свойству шины памяти. Что особенно актуально, к примеру, для видеообработки и других мультимедиа задач. Чем ближе память физически расположена к процессору, тем меньших упрочнений требует сотрудничество с ней: меньше задержки передачи данных и меньше помех, что разрешает расходовать меньше энергии на передачу данных.
Сложно представить микросхему памяти, расположенную ближе к процессору, чем лежащую на нем сверху. Важный довод в пользу как раз 3d TSV, а не просто 3d stacking’а: ширина шины памяти. Это в большинстве случаев десятки, либо кроме того много бит, и размещение шины таковой разрядности в специально предназначенных для I/O областях – сложная задача.
Применение же TSV дает в десятки раз громадную плотность размещения выводов и разрешает «сэкономить» как на занимаемой площади, так и на потребляемой мощности. И вдобавок, возможно, к примеру, расширить разрядность шины и за счет этого понизить частоту, оставаясь на том же уровне производительности.Новый стандарт памяти DRAM – Wide I/O, применяющий TSV для соединения с памятью через 512-битную шину, фактически удваивает пропускную свойство по сравнению со стандартом LPDDR2 (Low-Power Double Data Rate 2), оставаясь на том же уровне энергопотребления.Неоднородная интеграция.
В случае если речь заходит об изготовлении какого-либо устройства на поверхности кремниевой пластины, то поднимается вопрос о выборе технологических параметров. В рамках одной и той же технологии возможно делать выбор между, к примеру, величиной тока и быстродействием транзисторов утечки. Помимо этого, в случае если речь заходит о чем-то более мелкосерийном, чем процессоры, то вопрос выбора разработки также непрост.
Применение новейшего техпроцесса влекут за собой необходимость переделывать проектирование на физическом уровне для уже употреблявшихся ранее IP блоков. Это ухудшает таковой показатель, как переиспользование IP, влечет финансовые и, что серьёзнее, временные затраты.Применение 3d интеграции разрешает объединять в одно устройство части, изготовленные с различными технологическими параметрами, либо кроме того с применением различных технологических процессов.
Это разрешает во многих случаях взять преимущество. Для сравнения, приведу таблицу, показывающую оптимальные характеристики для фактически ячеек памяти и связанной с ними логики. Как видно, отличий множество.На этом до тех пор пока всё.
В следующей части я попытаюсь поведать о проблемах связанных с 3d интеграцией (в противном случае преимуществ большое количество, а где же их воплощение?) и закончить рассказ.
Случайная статья:
- От обычных часов к умным: переходный период
- Обзор sony smartband talk swr30: отличаются умом и сообразительностью
Интеграция планшета Nexus 7 в солнце защитный козырек.
Похожие статьи:
-
Трёхмерная интеграция: в чем трудности?
КДПВ справа – миниатюрнаякамера(62.5 тыс. пикселей), ставшая вероятной благодаря соединению с оптическим сенсором через TSVВ одном из прошлых постов, я…
-
Microsoft lumia 950 xl: интеграция с xbox
Недавний старт продаж Микрософт Lumia 950 и Lumia 950 XL ознаменовал новую эру, потому, что эти мобильные устройства поддерживают ОС Windows 10, вернее…
-
Учет рабочего времени на tibbo project system, интеграция с aggregate и 1с: предприятие 8
Мы уже говорили о том, что такое Tibbo Project System. В комментариях нас попросили собрать простое устройство, таковой себе «Hello World», дабы показать…


 Май 13, 2014
Май 13, 2014  intellcity
intellcity  Опубликовано в
Опубликовано в  Метки:
Метки: